|
|
|
晶片級封裝(Chip Scale Package,CSP)成為2013年LED業界最具話題性技術,相較於CSP技術已在半導體產業行之有年,CSP在LED產業仍屬先進技術,Philips Lumileds也在最新探討CSP技術文章中談到,CSP技術過去自在半導體(矽)的發展正是為了縮小封裝體積、改善散熱問題以及提升晶片可靠度,而業界已將CSP技術傳統定義為封裝體積與LED晶片相同,或是體積不大於LED晶片20%,且功能完整的封裝元件。
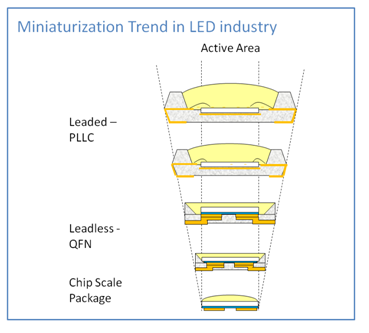
CSP技術在半導體產業的蓬勃發展來自於封裝體積微型化的發展與改善散熱問題,因應半導體晶片不斷微縮、接腳數不斷增加所衍生的需求。此外,CSP技術不但減少了器件寄生,還能提高 Level 2封裝的集成程度,Philips Lumileds認為,封裝技術的革新必然將延伸至半導體以外產業,LED產品在空間需求的特性下,CSP技術在LED產業的發展態勢已然成形。
根據Philips Lumileds研發中心高級副總裁Bhardwaj Jyoti與其團隊出具的CSP專文內容,業界多將CSP技術定義為封裝體積與LED晶片相同,或是封裝體積不大於LED晶片20%,且功能完整的封裝元件。典型的CSP技術不需要額外的次級基板(sub-mount)或是導線架,而是可以直接貼合在Level 2的載板上。CSP技術片級封裝進一步將P、N電極做在芯片底部並可用表面貼合方式組裝,相較於打線製程,CSP有助於封裝測試與組裝段標準化的推行,並且在不增加成本與複雜性的前提下進行。
而目前體積最小的CSP產品正是Flip Chip的封裝元件,而這也被業界稱作Wafer Level Package,根據Bhardwaj Jyoti的分析,傳統Flip Chip和CSP Flip Chip的不同之處在於,CSP Flip Chip已在晶片端做出電極層重組,也因此,P、N電極可以接以回流焊或是金錫共晶方式貼合在Level 2載板上,省略中介層、次級基板,或是其他型式的額外封裝製程。
Bhardwaj Jyoti指出,以目前封裝製程來看,高功率封裝以thin film晶片為基礎,再將晶片貼合到陶瓷基板上,再進行螢光粉塗布,而中低功率封裝則多以水平晶片為基礎,使用導線架並且需要打線製程,或是採QFN封裝型態,在噴塗螢光粉的方式進行。而CSP技術為高功率與中功率封裝型態帶來新選擇。
LED產業不斷追求越來越小的封裝體積,並且要在體積更小的情況下達到相同的出光率與發光效率,簡言之,在體積越小下達到相同出光與效率,「越小就越便宜」趨勢成形。另一方面,根據不同的應用,LED尺寸也牽動著光學設計,特別是在超高流明裝置下,像是COB產品等就可能碰到光學的限制,而CSP提供高封裝密度選擇,而SMD貼合方式也相當適合用於高速但同時追求低成本的自動貼合製程。
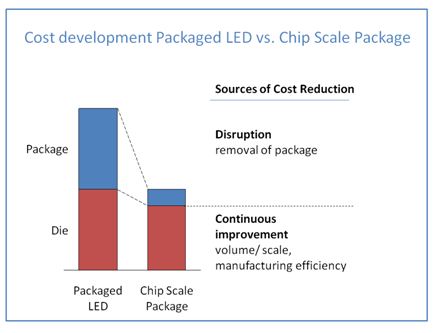
Philips Lumileds總結CSP優點
*散熱表現更佳
*高流明密度達到在同樣裝置達到更高流明值
*省略打線製程,產品可靠度提升
*高封裝密度
*採SMD貼合,簡化基板設計
*貼合方式具彈性